- 8 Haz 2024
- 10,202
- 5,654
- 4,424
Ziyaretçiler için gizlenmiş link,görmek için
Giriş yap veya üye ol.
Samsung, yeni nesil HBM4 bellek üretimini hedefleyen son teknoloji ürünü SAINT 3D paketleme hizmetlerini önümüzdeki yıl piyasaya sürmeye hazırlanıyor.
Samsung’un SAINT 3D Paketleme Teknolojisi Dikey İstifleme Sunarak Önemli Performans ve Verimlilik Artışları Sağlayacak
Koreli dev Samsung, yeni ve gelişmiş teknolojileriyle yapay zeka endüstrisinde üstünlük sağlamaya çalışıyor ve son yaptığı lansmanlarda tanıttığı yeni nesil 3D paketleme hizmetleriyle HBM segmentinde ön planda yer alıyor. Korea Economic Daily tarafından yayınlanan bir rapora göre Samsung, 2025 yılına kadar 3D paketleme hizmetleri sunmaya hazırlanıyor ve bunun 2026 yılına kadar piyasaya sürülecek olan bir sonraki HBM bellek standardı HBM4’e hazırlık olması bekleniyor.![Editoryal]Gelişmiş Paket Teknolojisi ile Dünyayı Sallıyoruz - Samsung Global Newsroom Editoryal]Gelişmiş Paket Teknolojisi ile Dünyayı Sallıyoruz - Samsung Global Newsroom](https://techolay.net/wp-content/uploads/2024/06/Samsung-HBM4-Hazirliklari-Kapsaminda-2025-Yilina-Kadar-SAINT-3D-Paketleme.jpg)
Samsung‘un yeni 3D paketleme ayrıntılarına bakıldığında, 2.5D yönteminin halefi olduğu görülüyor ve Koreli dev bu kez HBM ile GPU’yu birbirine bağlamak için bir silikonu istiflemek yerine, birden fazla çipseti üst üste istifleyerek dikey entegrasyona odaklanmaya karar verdi. Samsung bunu SAINT (Samsung Advanced Interconnect Technology) platformu olarak adlandırmayı planlıyor. Samsung bu platformu SAINT-S, SAINT-L ve SAINT-D olmak üzere üç türe ayırdı. Bunların hepsi SRAM, Logic ve DRAM gibi farklı çiplerle ilgilenmek üzere tasarlanıyor.
Samsung‘un yeni 3D paketleme teknolojisi, geleneksel 2.5D’ye kıyasla çeşitli avantajlar sunuyor. Dikey istifleme sayesinde firma çipler arasındaki mesafeyi azaltmayı başararak daha hızlı veri aktarımı sağlıyor. Dikey istifleme aynı zamanda karbon ayak izini de azaltıyor ve bu da teknolojinin yaygın olarak benimsenmesi için ek faydaları da beraberinde getiriyor.
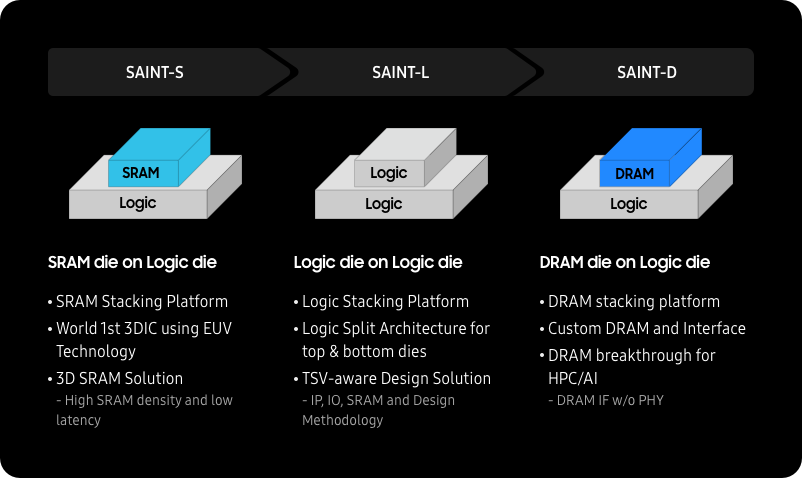
Kore medyası, Samsung‘un bu teknolojiyi Kaliforniya’daki Samsung Foundry Forum 2024’te sergilediğini iddia etti. Bu lansman, NVIDIA ve AMD’nin kendi yapay zeka donanımları için yaptığı duyuruları ışığında şirketin SAINT 3D paketleme teknolojisini ilk kez halka göstermesi olarak değerlendiriliyor. HBM4 ile 3D paketleme kullanılacağından ötürü, Samsung’un hizmetlerinin NVIDIA’nın Rubin mimarisi ve AMD’nin Instinct MI400 AI hızlandırıcıları ile beraber piyasaya sürülmesi bekleniyor.
Samsung ayrıca 2027 yılına kadar “hepsi bir arada heterojen entegrasyon” paketleme teknolojisini piyasaya sürmeyi planlıyor. Bu teknoloji, entegratörlerin ayrı paketleme teknikleriyle uğraşmak zorunda kalmadan tek bir birleşik AI paketini kullanmasına izin verecek.





